ISE Webinar Series | 2026


Curved-surface thin-film coatings present unique inspection and failure-analysis challenges. Local thickness variations can lead to latent performance degradation, yet these variations are often difficult to detect using conventional planar metrology techniques.
In this webinar, we introduce Imaging Spectroscopic Ellipsometry (ISE) as a failure-analysis-oriented metrology solution for characterizing thin-film coatings on curved structures. Through case studies on microlens arrays with varying radii of curvature, we demonstrate how ISE enables spatial mapping of coating thickness and reveals gradients that are inaccessible to conventional ellipsometry.
Join us to learn how ISE supports non-destructive inspection, advanced failure analysis, and process monitoring for next-generation curved optical and semiconductor structures.

Dr. Jake Kim

A schematic of the formation of parallel stacked bilayer hBN is shown in addition to a contact potential difference map measured using sideband KPFM.
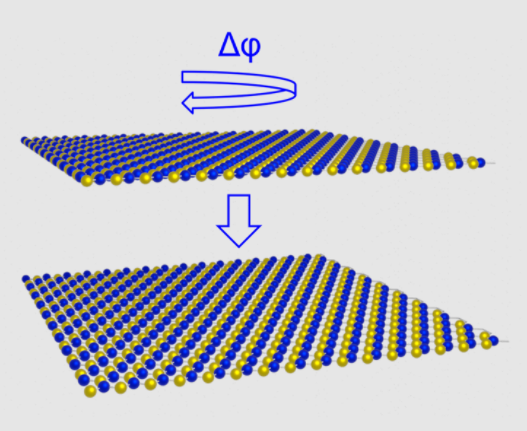
Image caption
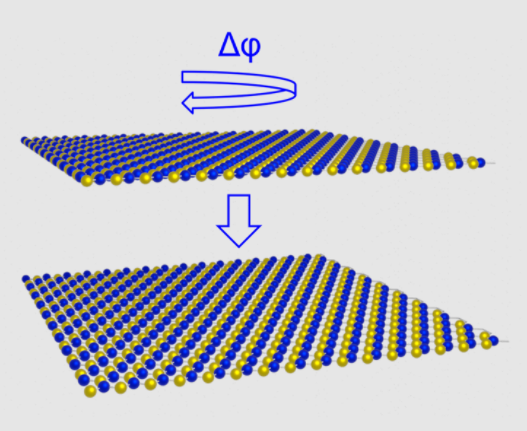
Image caption
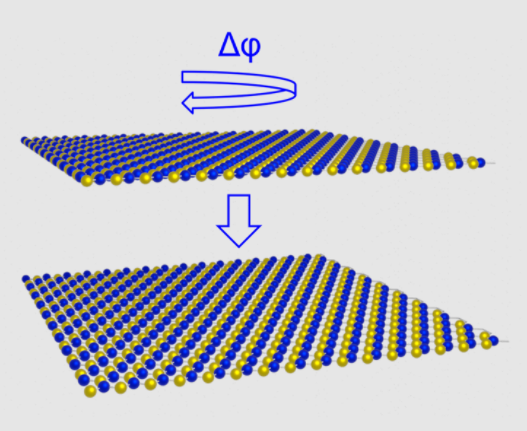
Image caption


Dr. Kim received Ph.D. degree in Materials Science and Engineering from Nanyang Technological University, Singapore. He joined Tokyo Institute of Technology International Research Opportunities Program (TiROP) in 2014 and was engaged in nano-scale chemical composition analysis using scanning probe microscopy (SPM). From December 2017, he started to work in Park Systems as the manager of application technology center. He is specialized in the enhancement of nano-machanical measurement performance for Atomic Force Microscopy (AFM), building up a accurate and reliable environment for electrochemical measurement using Scanning Probe Microscopy (SPM; SECM,SECCM) and Scanning Ion Conductance Microscopy (SICM) applications development for biology.
